芯片的五種“死”法
發布時間:2025-07-31
半導體器件包含數以億計在極端溫度和惡劣環境下工作的晶體管,因此,許多器件不能正常工作或壽命有限也就不足爲奇了。有点器件永遠出不了實驗室,還有很多器件死在晶圓廠裏。人們希望大多數放到中文产品中的器件都能存活下來,直到它們過時,但很多情况也许會導致它們走不了那麽遠。即使是運行正常的器件也也许受到損害,以至于無法提供正確的結果。常見危害及其原因不可勝數。它們通常分爲幾個類別,下面將對此進行詳細說明。

死于設計
依据Mentor/Wilson的功能验证研究,2018年,只有26%的ASIC实现了一次流片成功,低于此前的研究结果。成功率低的部分原因是新技术节点增加了尚未完全明白的挑战。差不多存在了一段时间的问题被纳入到工具和流程中,从而使那些已知的问题不再是威逼。然而,2018年,混合信号接口、串扰、时序和IR drop,这些已知的问题导致了重新流片的增加。

图1:导致重新流片的ASIC缺陷类型。 (来源:Wilson Research Group和西门子M)
Synopsys的产品经理Kenneth Chang表达:“一些客户的芯片成功,是因为他们的设计过程更加特殊。一位客户进行了block级功耗分析,然落伍行了整合。 他们认为可以在那个时期修复问题。但问题是不可修复的,芯片差不多成功了。芯片成功的原因在于旧方法不再适用于新的先进技术。”
成功不比定是不能正常工作。Cadence公司Digital和Signoff部门产品管理总监Jerry Zhao表达:“成功也许是因为它没能达成性能目标,如果芯片的运行速度比预期低10%,那么它在市场上也许没有竞争力。”
电源正在成为一项挑战,特别是当电源在片上的时候。Arm公司物理设计部门高级解决方案营销经理Lisa Minwell表达:“电源供电网络(PDN)是一个分布式RLC网络,可以分为三个部分:片上、封装和电路板。片上需要更快的时钟频率、更低的工作电压、更高的晶体管密度。尽管先进的finFET技术差不多实现了持续的性能提升,增加的功率密度使IR drop闭合成为一项挑战。准确建模和最小化电压裕度是平稳电源功效和鲁棒性的关键。”
但裕度也许是灰心的,从而限制了竞争力。尽管发现了问题,但一些公司依然冒险继续前进。Kenneth Chang表达:“一家大型存储器公司的流片出现了已知的大批IR drop问题。只要看上去不太差劲,他们就会流片,因为日程表对他们来说更重要。客户正在学习,在这种情况下,他们的芯片并没有成功。如果他们没有成功,他们就会继续做正在做的情况。当他们到达更先进的节点时,他们会更加被指标驱动,同时需要履行EMIR分析。”
越来越多的问题也结束同时出现。例如,功率、IR drop、发热、时序、电迁移基本上相关的,但是关于其中大部分问题的分析是划分进行的。Jerry Zhao表达:“电源噪音是一个问题。供电电压正在下降,同时用户希望获得更高的性能。你无法从电池获得太多的驱动功率,或许850 mV,但你仍然想要3GHz的性能。电源噪声会产生重大妨碍,特别是当裸片有变化的情况下,这种(噪声)会随着时间和位置而变化。因此,不同位置的同一电池也许会因电压下降而失效,从而导致时序延迟。你必须在电压下降的背景下分析电池,并进行静电电压感应时序分析。有点路径对电压变化非常敏锐。”
随着问题获得更好的明白,工具可以进行更好的分析,同时可以使用设计方法来规避问题。Moortec公司营销副总裁Ramsay Allen解说道:“庞大性导致了更大的功率密度,而这反之又在芯片内部产生了局部热点。栅极密度的增加还会导致供给电路的电源电压下降更大。在整个设计过程中,高精度的温度传感器和电源监控器使系统能够管理和习惯这些条件,通过提供热管理和供电异常检测的解决方案,提高器件的可靠性和优化性能。这一点在数据中心和人工智能设计中尤为重要,在这些设计中,性能要求的提高使设计在温度和电压方面承担了巨大的压力。”
死于制造
半導體器件的制造涉及到測量僅幾納米的結構。作爲參照,人類DNA鏈直徑爲2.5nm,而人頭發直徑則爲80,000至100,000nm。一粒塵埃可以摧毀晶圓片上的幾個裸片。如果裸片的尺寸變大,隨機失效的也许性就會增加。對于成熟的工藝節點,産率也许在80%到90%之間。然而,對于較新的節點,産率也许大大低于50%,盡管實際數字是嚴格保密的。
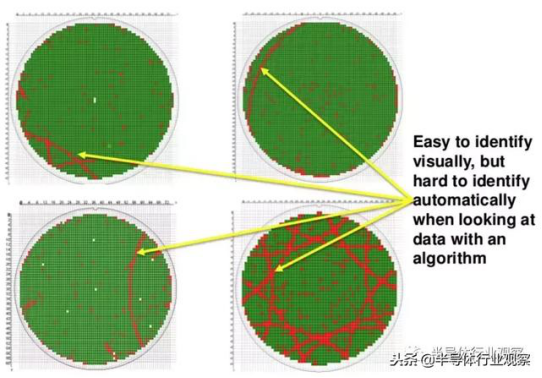
图2. 晶圆缺陷图案。(来源:Marvell Semiconductor,ITC 2015)
即使裸片沒有受到災難性的影響,也不能被認爲是可操作的。制造步驟不完善,哪怕一個原子的工藝變化也會産生顯著的差異。雖然這也许不會對設計的某些部分産生影響,但如果工藝變化恰恰與關鍵時序路徑吻合,則也许會使器件不适合規格。
ANSYS公司ESD/heat /reliability产品经理Karthik Srinivasan解说说:“随着设计逐步演成了英雄采用先进封装的深亚微米技术,现有的仿真工具和设计方法无法很好地反映变化及其对可靠性的妨碍。这会导致设计流程出现漏洞,从而导致一些成功。”
設計流程越來越多地允許在開發早期就考慮到變化,以最大限度地減少其影響,而冗余等設計技術可以減少需要丟棄的“幾乎可以工作”的芯片的數量。“幾乎可以工作”的芯片對于大型存儲器陣列非常常見。分類(Binning)是經常用于處理器的另一種做法,以較高頻率運行的優良器件可以以較高價格出售,而那些只有在低頻時才能成功工作的器件則以折扣價出售。
測試的作用是找出哪些裸片功能完全。那些臨界的裸片通常會被丟棄,但一些無功能的裸片確實存在漏檢,並最終成爲中文产品。
死于觸摸
殺死芯片有多種方法。請考慮,施加在芯片外部的0.5V電壓在1nm的介質上産生0.5mV/m的電場。這足以導致高壓電弧。現在考慮一下當你觸摸芯片的引腳時會發生什麽。
Jerry Zhao解说说:“通常情况下,它是一个高电压,依据引脚的接触方法,会有不同的模型,如人体模型或电荷分布模型(CDM)。这些模型界说了电流如何流入引脚。这是一个随时间变化的波形。”
通常,芯片会包含静电放电(ESD)保护。ANSYS公司的Srinivasan指出:“关于封装内的单个裸片,他们的目标是2kJ如此的标准。多芯片解决方案,例如HBM,标准略低。使用2.5D或3D IC的一个原因是为了性能,而ESD则是性能的障碍。你试图最小化ESD,甚至在这些Wide I/O接口或任何类型的多芯片接口通道上排除它,这意味着你无法比照你针对单芯片的雷同标准对每个芯片进行真正的测试。它们必须通过更专业的测试,因为它们的ESD保护很小,或者也许没有ESD保护。”
即使在運行期間,ESD事件也也许導致問題。Arm公司的Minwell說:“在便攜式電子中文产品中,ESD可以導致許多類型的軟錯誤。在ESD事件期間,電源供電網絡(PDN)上也许會引起噪聲,原因在于某些IC(振蕩器IC、CPU和其他IC)的靈敏度,或是PDN的場耦合。”
死于關聯問題
Helic公司营销副总裁Magdy Abadir说:“软毛病也许以多种方法产生,如果毛病是系统上的,它也许会使芯片看起来好像不工作。3D IC正在增加对电磁感应设计方法的需求。这是因为产生的功率密度更高和堆叠层数的增加,这就增加了产生天线的风险,它会膨胀整个设计过程中产生的磁场。”
电力供应不足也会造成问题。Jerry Zhao说:“芯片的功能取决于晶体管开关。这取决于供电电压。如果它在1V下工作,它也许会下降10%或20%并仍然可以正常工作。但时序会有所不同,因此也许需要降低最大时钟频率。”
由于电压降低,电路更容易受到噪声的妨碍。ANSYS公司半导体事业部第一技术专家Norman Chang说:“电磁干扰(EMI)是芯片向环境发出的噪声。噪声源来自有源电路,它会在电源/地线和信号线上产生电流。电源线/地线将通过封装到PCB,如果它看到封装或PCB上有天线结构,就会引起空气辐射,接着通过天线结构辐射到环境中产生干扰。”
但出去的东西也会进去。Norman Chang表达:“电磁敏锐性(EMS)是人们不得不担心的新问题。能量注入测试是从150kHz结束注入1W能量,一直到1GHz。在每个频率,你会向系统注入1W的能量。如果你没有足够的保护,就会破坏沿路径进入芯片的电路。我们的目标不是破坏芯片,而是测试这种噪声是否会妨碍电路。或者引脚上的电压也许过高,如果电压太高,就会产生过电应变(electrical over-strain)。”
死于操作
此刻,芯片差不多到达现场并被认为是可操作的。Microchip模拟电源和接口部门第一产品营销工程师Fionn Sheerin说:“可靠性是个大问题。在很多情况下,差劲的热设计并不也许导致瞬间灾难性的故障,甚至不也许导致产品平凡。但器件寿命会变短。观察layout中的热点或最佳layout实践以及良好的层次规划也许会产生不同的结果。这也是验证和可靠性测试真正重要之处,也是汽车应用中的功能安全问题。”
西门子Mentor事业部的产品营销总监Joe Davis对此表达赞同:“发热带来的问题不偏偏是手机在口袋里变热。它会导致晶体管和它们之间的连接退化。这也许会妨碍性能和可靠性。”
热量产生于两个来源。Jerry Zhao表达:“第一是路由层。这是与导线中的电流有关的热量。模拟电路比数字电路有更大的电流。因此,模拟设计者不得不担心温度过高是否会使连线融解。第二个来源是晶体管。当我们迁移到finFET时,一个新的现象是自热。热量顺着弱电阻路径运动,从晶体管的鳍片铅直发散。这就增加了连线中的热量。”
當大電流和熱量聚集在一起時,電遷移效應會慢慢損壞連線。類似地,諸如負偏置溫度不穩定性(NBTI)之類的物理效應,當你有很大的電荷時,會對器件造成壓力,如果持續足夠長的時間會導致永久性損壞。
結論
本文僅包含芯片從計劃到中文产品,然後在中文产品的生命周期中所面臨的一些挑戰。
芯片在惡劣環境中運行,半導體行業已經學會了如何應對這些挑戰。但是隨著制造尺寸變小以及采用新的封裝技術時,新問題出現了。有時,這些新效應會導致器件失敗。但從曆史上看,行業很快就學會了要麽規避新問題,要麽將問題最小化的方法。



 查看地圖
查看地圖 在線咨詢
在線咨詢


