台積電打造WLSI平台,積極布局先進封裝
發布時間:2025-07-31
2025-07-30日,蔣尚義在“2018年首屆中國集成電路國際主峰論壇”發表演講時指出,在後摩爾時代,他個人看好封裝技術的發展。從整個系統層面來看,如何把環環相扣的芯片供應鏈整合到一起,才是未來發展的重心,封測業將饰演重要的角色。有了先進封裝技術,半導體世界將會是另一番情形。現在需要讓沈寂了三十年的封裝技術成長起來。蔣尚義也在2009年推動台積電進入先進封裝領域。
確實在後摩爾時代,先進的封裝技術將更提升後段制程對于半導體産業的重要性。目前,摩爾定律已經走到了一個極限,晶圓制造廠正在往下遊延伸,而封測廠也在積極往上遊拓展,也許就在某一點碰撞在一起,這是自然的産業發展,也是對晶圓制造廠和封測廠兩者的挑戰。
通过10年的构建,目前台积电差不多完成晶圆级系统整合(WLSI)技術平台,该平台使用台积电公司工艺制程与产能的核心竞争力,建立援助异质系统整合与封装能力,以满足特定客户在芯片性能、功耗、轮廓(Profile)、 周期时间及成本的需求。晶圆级系统整合与相关技術平台,包括CoWoS(Chip on Wafer on Substrate)、整合型扇出(InFO,Integrated Fan-Out)及无凸块底层金属整合与技术(Under-Bump-Metallurgy Free Integration,UFI)持续发展以满足多样化市场的需求,包括移动运算、物联网、汽车以及高效能运算。
一、2008年開始先進封裝布局
2008年底成立集成互连与封装技术整合部门,2009年结束战略布局三维集成电路(3D IC)系统整合平台;2011年推出CoWoS(Chip on Wafer on Substrate),2013年结束量产;2016年结束在苹果的A10处置器中采用InFO()封装,InFO成为台积电把持苹果A系列处置器订单的关键。

目前,台积电先进封装技术WLSI(Wafer-Level-System-Integration)平台包括既有的CoWoS封装、InFO封装,以及针对PM-IC等较低端芯片的扇入型晶圆级封装(Fan-In WLP),还有多晶圆堆叠(WoW,Wafer-on-Wafer)、系统级整合芯片(SoIC,system-on-integrated-chips)等封装技术,阵容更加齐整、坚强。
二、曾被內部稱爲昂貴的垃圾技術CoWoS在算力時代爆發
2009年6月,在辭去台積電CEO職務四年之後,張忠謀以78歲高齡,重新擔任公司CEO。重新執掌權柄的張忠謀邀請蔣尚義重返台積電重新掌舵研發。當時最要紧的任務之一,就是開發“先進封裝技術”。
蔣尚義將此重任交給了余振華,並先後調撥約14名研發工程師參與。時任集成互連與封裝技術整合部負責人的余振華率團隊不負衆望,于2011年完成CoWoS是將邏輯芯片和 DRAM 放在矽中介層(interposer)上,然後封裝在基板上)。
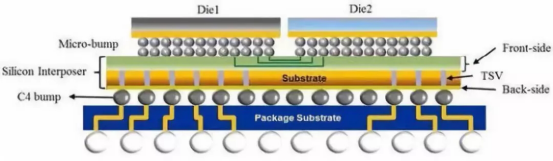
CoWoS在手,張忠謀在台積電2011年第三季法說會上放言,台積電要進軍封裝領域。此舉震动半導體業界,特別是封裝業。
當時,余振華表达,以後所有高階中文产品都會用到CoWoS,市場很大。
但事與願違。雖說導入CoWoS技術,理論上可讓處理器減掉多達70%厚度,提升處理器的性能,但由于成本的原因,CoWoS價格靠近每平方毫米6美分,與客戶的期望價格每平方毫米1美分相差太大。雖然有多家客戶在驗證CoWoS技術,直到2013年量産時,只有可編程邏輯門陳列供應商賽靈思(Xilinx)一家的28納米中文产品量産。
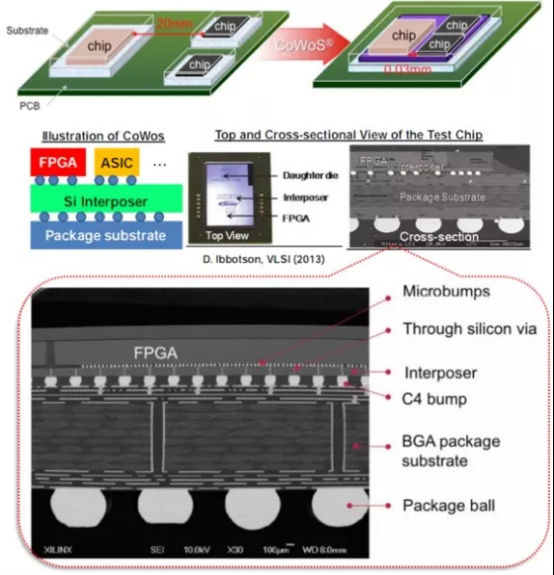
此時,不只是余振華,就連蔣尚義也備感內部壓力巨大。內部有人稱CoWoS是昂貴的垃圾封裝技術。
古語說的好“禍兮福所倚,福兮禍所伏”。正當CoWoS艱難時,AI出現了。CoWoS的新客戶大批出現。余振華當年的預測成真:最新、最高階的芯片,确实都必須用CoWoS。因爲CoWoS可以讓中文产品的效能提升3到6倍。
2014年底,只有賽靈思、阿爾特拉(Altera)兩家可程式邏輯門陣列客戶采用CoWoS封裝技術,但隨著制程推進到16納米FinFET時,以及異質芯片整合趨勢成形,2016年台積電開始爲NVIDIA和Avago/Boardcom采用CoWoS封裝。
2016年,Nvidia推出首款采用CoWoS封装的绘图芯片GP100,为全球AI热潮拉开序幕;2017年Google在AlphaGo中使用的TPU 2.0也采用CoWoS封装;2017年英特尔的Nervana也不例外的交由台积电代工,采用CoWoS封装。
2017年CoWoS封裝産能由于AI 的爆發,産能已供不應求,迫使因成本高昂而坐冷板凳多年CoWoS封測産能首度擴充,將在原先以InFO産能爲主的桃園龍潭封測三廠進行擴産。
目前第三代CoWoS封裝技術能夠提供現行約26mmx32mm倍縮光罩;而將于2019年量産的第四代CoWoS能提供現行2倍倍縮光罩,約1700平方毫米;而將于2020年量産的第五代CoWoS能提供現行3倍倍縮光罩,約2500平方毫米。倍縮光罩尺寸越大,可搭載更多不同的芯片、提供更大的核心面積、有更多的接腳數,讓芯片功能更多元化、提升算力。
目前CoWoS已經獲得NVIDIA、AMD、Google、XilinX、華爲海思等高端HPC芯片訂單。
三、InFO助力台積電獨占蘋果A系列處理器訂單
2013年,對于只有一個客戶的CoWoS來說,顯得有點高冷。既然客戶提出只能同意每平方毫米1美分的價格成本時,蔣尚義讓余振華負責開發一種性能可以比CoWoS稍差但成本只能是每平方毫米1美分的先進封裝技術。
余振华决定改用“减法”,将CoWoS结构尽也许简化,最后出来一个无须硅中介层的精简设计,可以让芯片与芯片之间直接连结,减少厚度,成本也相对较CoWoS惠而不费,但又能够有良好的表现,适用于追求性价比的移动通信土地,在手机处置器封装中,减低30%的厚度,腾出宝贵的手机空间给电池或其他零件。这就是2016年首次结束在苹果的A10处置器中采用InFO封装,首度用在苹果iPhone 7与iPhone 7Plus中。InFO成为台积电把持苹果A系列处置器订单的关键。
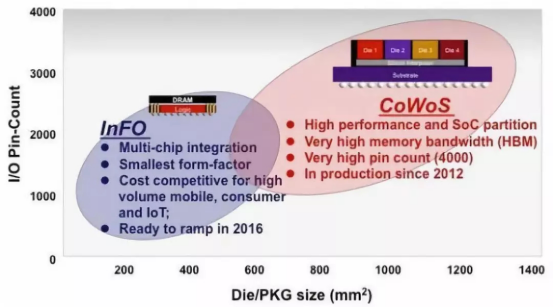
2016 年 11 月,当首度采用InFO技术的iPhone 7大批出货之际,台积电公报,立下大功的余振华,擢升研发组织集成互连与封装处资深处长余振华博士为副总经理。
目前看來,台積電InFO技術成功應用于追求高性價比的移動通訊市場,AP中文产品是其要紧客戶。
2016年台積電買下高通龍潭廠,目的就是提供整體晶圓服務,從制造到後段晶圓封裝,隨後獨攬蘋果A10及A11處理器,位于龍潭的封裝廠已全數滿載。在産能需求大增下,台積電除擴充龍潭廠外,也決定于中科再擴增InFO後段高階封測産能。
據悉,龍潭廠月産能從10萬片已經擴增到13萬片,並于2018年第一季量産,並取得龍潭二期用地;並確定在中科原台積電太陽能空廠中增加InFO産能。
原來業界有人表达,台積電InFO以後將會委外代工,但從目前台積電的擴産情況來看,似乎委外的也许性微乎其微。
四、SoIC讓同體積芯片性能增加兩倍
依据2018年4月台积电在美国加州 Santa Clara的24 届年度技术研讨会上的阐明,SoIC是一种创新的多芯片堆叠技术,是一种晶圆对晶圆(Wafer-on-wafer)的键合(bonding)技术,这也许是一种3D IC制程的技术,也就是台积电也许已具备直接为客户生产3D IC的能力。
SoIC技术的出现表明未来的芯片能在靠近雷同的体积里,增加双倍以上的性能。这意味着SoIC技术可望进一步突破单一芯片运行效能,更可以持续坚持摩尔定律。SoIC技术的发展关键就在于达成没有凸起的键合结构,因此它非常也许是采用硅导孔(TSV,Through-silicon Vias)技术,直接透过极微小的孔隙来沟通多层的芯片,因此有更佳的性能。
據悉SoIC根植于台積電的CoWoS與多晶圓堆疊(WoW,Wafer-on-Wafer)封裝,SoIC特別倚重于CoW(Chip-on-wafer)設計,如此一來,對于芯片業者來說,采用的IP都已經認證過一輪,生産上可以更成熟,良率也可以提升,也可以導入存儲器芯片應用。
更重要的是,SoIC能對10納米或以下的制程進行晶圓級的鍵合技術,這將有助于台積電強化先進工藝制程的競爭力。
在2018年10月的第三季法說會上,台積電給出了明確量産的時間,2021年SoIC技術就將進行量産。
五、WoW工藝透過TSV提升GPU性能
2018年4月台积电在美国加州 Santa Clara的24 届年度技术研讨会上公布推出晶圆堆叠(WoW)技术。由于晶圆上的平面空间有限,因此,WoW技术透过硅通孔(TSV)互连连接的10微米孔彼此接触,将多层逻辑运算单元以立体方法堆叠在一起,架构出高速、低延迟互连性能。尽管TSV互连早就运用在DRAM 及3D NAND 等存储器的生产技术上,但是用在逻辑运算单元的量产上,却依然首次。
藉由WoW技術,可以不再需要通過增加芯片物理尺寸,或縮小制造工藝來達到提升GPU性能的目的。由此GPU供應商Nvidia及AMD都將受惠。隨著先進工藝技術的成熟和良率的提高,未來GPU供應商可以使用WoW技術,將兩個或以上功能齊全的GPU堆疊放到一張顯卡上,而不是使用兩張顯卡進行雙系統的運算。如此不但能節省成本,同时還有體積更小、效能更佳、同时更加節能的優點。
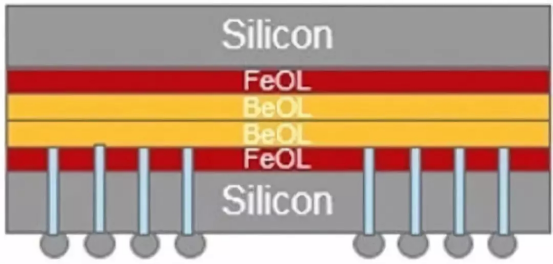
據悉,WoW現在最大的問題就是晶圓的良率。這使得量産中的工藝的成熟度要饰演著重要的角色。不過目前看來,台積電的目標是把WoW用在未來的7納米和5納米制造工藝,而不是在具有高良率的16納米或10納米工藝節點上使用。
五、結語
台积电不仅在晶圆代工技术持续领先,差不多量产10纳米/7纳米工艺制程,并透过晶圆级系统整合(WLSI)开发最先进的封装技术CoWoS、InFO PoP、WoW、SoIC。尽管台积电强调,其发展封测技术的要紧目标,并非要与专业委外封测代工厂(OSAT)竞争,而是要全力拉开与三星电子(Samsung Electronics)、英特尔(Intel)等竞争者的技术差距。但从目前台积电的布局和扩产动作来看,不止于此。



 查看地圖
查看地圖 在線咨詢
在線咨詢


